據(jù)悉,臺積電準(zhǔn)備將CoWoS封裝技術(shù)的產(chǎn)能從每月8000片wafer,提升到今年底的11000 WPM;而到2024年底則要到20000WPM。新的封裝技術(shù)已經(jīng)出現(xiàn),對于傳統(tǒng)的封裝手段,是否應(yīng)該擯棄呢?
封裝工藝
封裝是芯片中非常重要的異性工藝,封裝技術(shù)會影響到芯片后期的使用效果。
2.5D/3D封裝工藝
前不久臺積電剛剛開啟了先進(jìn)后道Fab 6工廠(Advanced Backend Fab 6),針對前道3D堆疊SoIC技術(shù)(包括CoW和WoW)和后道3D封裝技術(shù)(InFO和CoWoS)做產(chǎn)能擴(kuò)充。這家工廠的部分能力和產(chǎn)能對于多chiplet封裝與測試很重要。
目前臺積電CoWoS(Chip-on-Wafer-on-Substrate)先進(jìn)封裝技術(shù)最大的客戶就是英偉達(dá)和AMD,隨后是博通(Broadcom)。
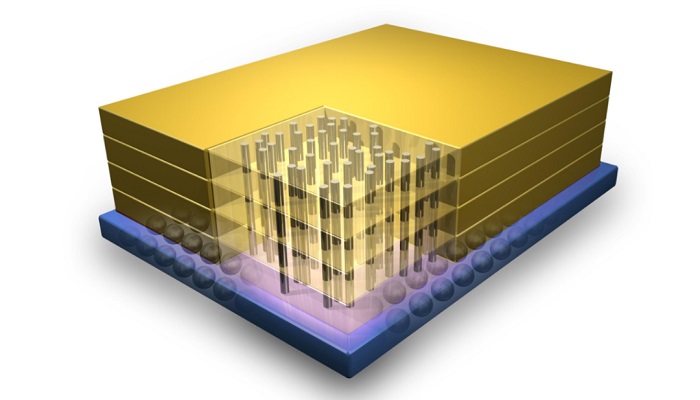
封裝技術(shù)現(xiàn)狀
關(guān)于先進(jìn)封裝技術(shù),主要涉及到三個部分,邏輯與存儲芯片IDM、具備先進(jìn)或成熟工藝的foundry廠、OSAT。
越早署先進(jìn)封裝技術(shù),處于領(lǐng)跑位置的參與者,必然是戰(zhàn)局里的贏家,即便初期產(chǎn)能受限,可能會成為其阻礙。
麥肯錫認(rèn)為,在高端的先進(jìn)封裝市場,OSAT以及技術(shù)水平處在較低級別的foundry和IDM,這些角色的發(fā)揮空間會很有限。
2.5D封裝應(yīng)用主要來自HPC應(yīng)用,以數(shù)據(jù)中心為主。其實(shí)Intel最近改變桌面CPU的系列產(chǎn)品命名,將Meteor Lake稱作“英特爾酷睿Ultra”第1代處理器,就可以看做PC行業(yè)步入2.5D/3D先進(jìn)封裝的標(biāo)志。3D封裝,可以用于大規(guī)模AI芯片。
回到標(biāo)題,傳統(tǒng)技術(shù)是否該被淘汰?就目前來說,新的封裝技術(shù)還沒有廣泛的使用,傳統(tǒng)的封裝技術(shù)依然有其突出的性能優(yōu)勢。所以現(xiàn)在就淘汰傳統(tǒng)封裝技術(shù)是非常不現(xiàn)實(shí)的,以后隨著技術(shù)的進(jìn)步,產(chǎn)品的更迭,新的封裝技術(shù)可能會逐漸取代傳統(tǒng)封裝技術(shù)。
 微信掃碼 關(guān)注我們
微信掃碼 關(guān)注我們

24小時咨詢熱線15915310670

移動電話15915310670
Copyright ? 2002-2022 長龍鑫 版權(quán)所有 Powered by EyouCms 地址:廣東省深圳市寶安區(qū)新安街道創(chuàng)業(yè)二路 新一代信息技術(shù)產(chǎn)業(yè)園C座623號 備案號:粵ICP備17052896號 網(wǎng)站地圖